RF

Precision Packaging for High-Frequency Performance
We deliver advanced RF and microwave packaging solutions designed to meet the demanding performance standards of modern high-frequency applications. Our expertise spans a wide range of package families, ranging from open-cavity QFN for sensitive analog and mixed-signal devices to flip-chip BGAs and complete RF modules, and can be customized for specific applications.
With deep knowledge in materials science, RF design, and assembly processes, we offer packaging solutions that ensure low insertion loss, controlled impedance, high reliability, and manufacturability at scale.
Talk to an Expert
With deep knowledge in materials science, RF design, and assembly processes, we offer packaging solutions that ensure low insertion loss, controlled impedance, high reliability, and manufacturability at scale.
Talk to an Expert

Why Partner with izmomicro?
01
Proven RF Co-Design Expertise
Benefit from deep experience in RF simulation and package co-design to optimize performance and reliability.
02
Versatile Process Capabilities
From wire bond and flip-chip to over mold and open-cavity packages, we support a broad range of assembly technologies
03
End-to-End Engineering Support
Comprehensive services covering substrate/layout design, assembly, testing, and qualification.
04
Cross-Industry Experience
Trusted by customers across commercial, automotive, and telecom sectors.
05
Certified World-Class Infrastructure
Our ISO 9001:2015 certified facility ensures high-quality manufacturing in a cost-efficient environment.
Bespoke IC Architecture for Quick-To-Market Applications
Open-Cavity QFN Packages
- Ideal for RF front-end devices, MMICs, power amplifiers, and LNAs.
- Supports exposed die attach area for direct access to bond pads, enabling precision wire bonding and minimal parasitics.
- Designed with low-inductance ground paths and thermal vias for superior RF and thermal performance.
- Compatible with Au, Cu, or Al wire bonding and high-reliability assembly requirements.
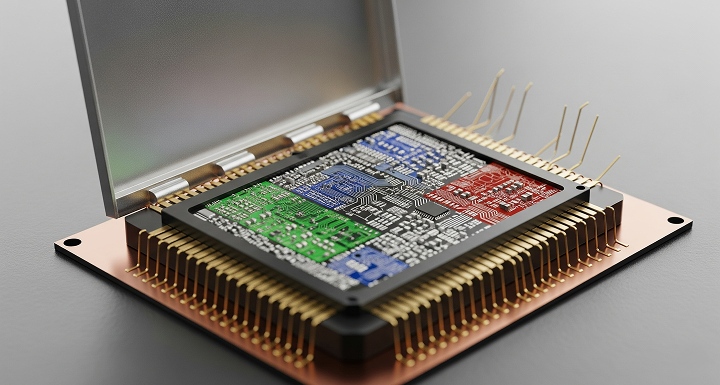

Molded QFN Packages
- Fully encapsulated QFN with robust mechanical and environmental protection.
- Optimized lead frame and pad design for 50Ω controlled impedance transitions.
- Excellent for high-volume manufacturing with cost efficiency, while maintaining RF performance up to mm Wave bands.
- Options for dual-row QFN and exposed pad configurations for power/RF co-integration.
Flip-Chip BGA (FCBGA)
- Supports high-frequency signal routing with short interconnect paths for reduced loss and improved bandwidth.
- Organic or ABF substrates with low-loss dielectric materials.
- Cu pillar or solder bump attach for advanced MMICs and RF SoCs.
- Enables integration of high-I/O devices, multi-die configurations, and antenna-in-package (AiP) implementations.
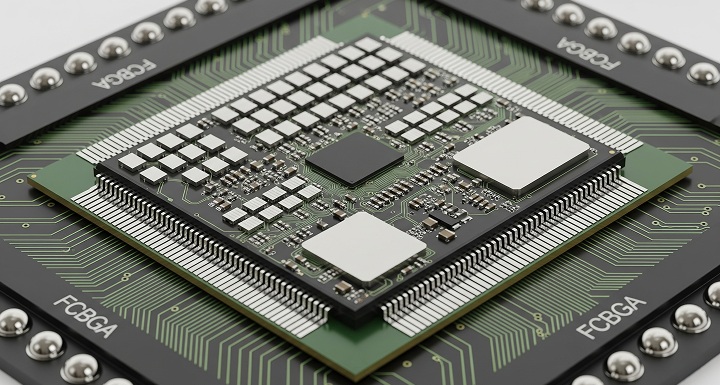

RF Module Assembly
- Complete multi-chip RF systems including filters, duplexers, power amplifiers, switches, and matching networks.
- Integration of passive components, SAW/BAW filters, and antennas into compact modules.
- Advanced SiP techniques for combining digital, RF, and analog dies into a single package.
- Hermetic and non-hermetic options depending on reliability requirements.
- Applications include 5G, Wi-Fi, IoT, satellite communications, radar, and defense electronics.
Need Help?
Consult with one of our technical experts today. Kindly share your contact details, and we’ll get in touch promptly.

